前言
点胶工艺是SMT制造链中“隐形的核心”,而高分子胶粘剂则是这一工艺的“血液”——它不似贴片、回流焊那般直观,却直接决定了电子产品的可靠性、耐用性与市场竞争力。从精密芯片的底部填充到元器件的临时固定,从高功率器件的散热传导到敏感组件的应力缓冲,胶粘剂的每一项性能都与产品的生命周期深度绑定。
本章将以SMT工程实践为核心,系统性总结点胶工艺中高分子胶粘剂的核心知识,打破“理论与实践脱节”的壁垒:从分子结构的本质出发,解读主流胶粘剂的性能差异;以行业标杆产品为载体,量化关键性能指标的工程意义;结合真实失效案例,剖析固化机理与工艺优化的关联;最终落地到选型原则与全生命周期管理,为SMT工艺工程师、材料工程师提供可直接参考、可落地执行的专业指南。

本章核心目标:构建“微观分子-宏观性能-工艺应用-质量管控”的完整知识体系,帮助从业者从“会用胶”升级为“善选胶、善用胶、善管胶”,真正发挥胶粘剂在SMT工艺中的核心价值。
2.1 核心认知:高分子胶粘剂——SMT点胶的“血液本质”
在SMT制造的“交响乐”中,点胶工艺是维系整个生产流程稳定高效的“生命线”,而高分子胶粘剂则是这条生命线上流动的“血液”。它绝非普通意义上的“胶水”,而是凝聚了材料科学、化学工程与电子制造工艺智慧的精密功能材料——其性能直接决定了封装的可靠性、生产的效率与产品的市场竞争力。

从工程实践角度看,高分子胶粘剂的核心价值体现在三大维度:一是“连接功能”,实现芯片、元器件与基板的牢固粘接,替代传统机械固定,适配电子产品小型化、集成化的发展趋势;二是“保护功能”,形成致密保护层,阻隔水汽、灰尘、溶剂等外界干扰,提升产品环境适应性;三是“辅助功能”,承担散热、导电、电磁屏蔽等特殊需求,支撑高功率、高精密电子产品的研发与生产。
SMT领域常用的高分子胶粘剂主要分为四大类:环氧树脂、有机硅、丙烯酸酯、聚氨酯。这四类胶粘剂因分子结构的差异,形成了截然不同的性能特点,适配不同的工程场景——如同人体血液的不同成分,各自承担着独特的“生理功能”。掌握它们的分子结构与性能关联,是做好点胶工艺的基础,也是SMT资深工程师的核心素养之一。
2.2 四大主流胶粘剂:分子结构、性能图谱与工程应用
高分子胶粘剂的宏观性能,本质上是其微观分子结构、分子链构象及交联网络形态的直接体现。本节将结合汉高、陶氏、铟泰、Panacol、DELO等行业巨头的明星产品,系统总结四大类胶粘剂的核心特性、产品实例与工程定位,为从业者提供清晰的“选型参考图谱”。
2.2.1 环氧树脂:SMT封装的“结构骨架”(高强高刚首选)
2.2.1.1 分子结构核心总结

环氧树脂的核心是含两个及以上环氧基团的环氧低聚物,最常用的双酚A型环氧树脂,分子主链由“苯环(提供刚性)+ 醚键(-O-,提供柔性)”交替构成,两端为高活性环氧基——这种结构赋予其“刚柔并济”的潜力,但液态环氧树脂本身仅为预聚物,需与胺类、酸酐类固化剂发生开环加成反应,形成三维网状交联结构,才能发挥优异的机械与热性能。

关键点总结:交联密度决定环氧树脂的核心性能——交联密度越高,刚性、强度、耐化学性越好,但韧性越差;固化剂类型决定耐温性,芳香族胺、酸酐类固化剂可显著提升耐高温能力。
2.2.1.2 性能图谱与标杆产品解读
环氧树脂的核心优势的是“高强高刚、低收缩、耐化学性优异”,短板是韧性不足,需通过增韧改性弥补。结合行业标杆产品的参数,其性能特点与应用场景可总结如下:
1.高粘接强度与高模量:固化后交联网络密度高,分子链间作用力强,苯环结构提升刚性与硬度,剪切强度、拉伸强度优异。
产品实例:汉高乐泰EA 9494(倒装芯片/BGA底部填充专用),TDS标注Tg=155°C(DMA,10Hz),固化后模量>9GPa,可提供极强的机械支撑,适配高可靠性封装场景,是高端电子设备底部填充的首选产品,完美诠释了“高交联密度+刚性骨架”的性能优势。(TDS---它是产品供应商提供的关于材料或产品的技术文档,包含产品的各项性能参数、物理化学特性、使用条件、应用范围等信息,相当于产品的“技术说明书”。)

2.优异的耐化学性与低收缩率:致密的交联网络可有效阻隔水汽、溶剂等小分子渗透;固化收缩率低于其他树脂,可减少精密封装中的内应力,防止器件变形。
产品实例:铟泰(Indium)UF系列底部填充胶,以极低的固化收缩率闻名,尤其适用于大型、精细间距封装(如精密BGA、CSP),可有效避免封装过程中因收缩不均导致的焊点开裂。
3.耐温性可调:耐温性主要取决于固化剂类型与交联密度,通过选用耐高温固化剂(芳香族胺、酸酐)或引入耐热骨架(酚醛环氧、萘环环氧),Tg可提升至200°C以上,适配高温应用场景(如汽车电子、工业控制)。
4.韧性不足(可改性):高度交联的网络结构导致“硬而脆”,需添加核-壳橡胶、热塑性弹性体等增韧剂改性。
产品实例:汉高乐泰3525(增韧型环氧结构胶),断裂韧性远高于标准环氧,剪切强度可达22MPa,适用于抗冲击要求高的场景(如便携式设备结构粘接)。

2.2.1.3 工程应用定位
环氧树脂是SMT封装中的“主力军”,核心适配场景为“对机械强度、尺寸稳定性、耐化学性要求极高”的场合,具体包括:
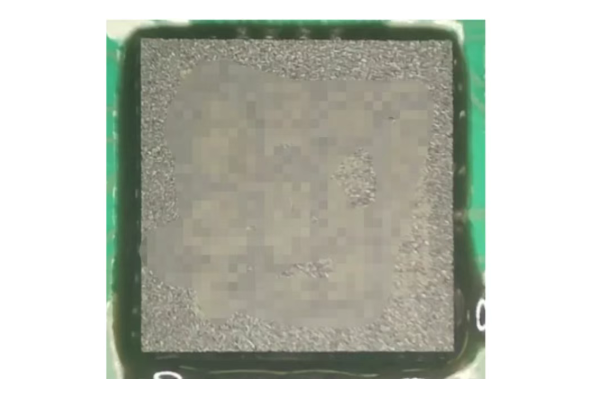

•高可靠性封装:BGA/CSP底部填充(Loctite EA 9494、Indium UF8900)、芯片粘接;
•结构加固:元器件加固、PCB板局部补强;
•高温场景:汽车发动机舱电子元件、工业控制设备的粘接与封装。
注意点:在抗冲击、高韧性需求场景中,需优先选用增韧型环氧树脂,避免因脆性断裂导致产品失效。
2.2.2 有机硅:应力管理的“弹性皮肤”(宽温域首选)
2.2.2.1 分子结构核心总结

有机硅聚合物的核心区别于其他胶粘剂的是“主链结构”——并非传统碳链,而是由硅(Si)和氧(O)交替连接的-Si-O-结构,侧基连接甲基(-CH₃)、苯基(-C₆H₅)等有机基团。Si-O键的键能(约444kJ/mol)远高于C-C键(约346kJ/mol),且键长更长、键角更大,使得分子主链具有极高的柔顺性和旋转自由度,这是其“宽温域、高柔性”的核心根源。
关键点总结:Si-O主链决定了有机硅的耐高低温性与柔韧性;侧基类型影响其相容性与电气性能;固化方式多为室温硫化(RTV)、热硫化,固化后形成弹性体,模量低、断裂伸长率高。
2.2.2.2 性能图谱与标杆产品解读(结合TDS参数)
有机硅的核心优势是“宽温域、高柔性、优异的电气绝缘性”,短板是粘接强度、机械强度较低,需通过底涂剂改善粘接性能。结合陶氏等行业标杆产品的TDS参数,其性能特点与应用场景总结如下:

1.卓越的耐高低温性:Si-O主链的高键能与分子链的高柔顺性,使其在-60°C~250°C(甚至更高)温度范围内保持弹性,Tg通常低于-50°C,可适配极寒、极热环境。
产品实例:陶氏DOWSIL™ 3-6750(RTV有机硅密封胶),TDS标注工作温度范围-55°C~200°C,无明显Tg拐点,适用于极端环境下的密封与保护(如户外电子、车载电子),完美体现有机硅的宽温域优势。
2.优异的柔韧性与低模量:固化后为弹性体,模量低(通常为MPa级别),断裂伸长率高,可有效吸收、分散热应力、机械振动与冲击应力,是应力缓冲的理想材料。
3.出色的电气绝缘性与耐候性:介电性能优异,耐紫外线、耐臭氧、耐湿气能力强,可长期在户外或潮湿环境中使用,不老化、不失效。
产品实例:陶氏DOWSIL™ 1-2577(共形覆膜胶),介电

常数低、耐湿性好,用于PCB板共形覆膜,可有效保护电路免受环境干扰。
4.粘接强度与机械强度较低:表面能低,与金属、陶瓷等基材的粘接力弱于环氧树脂,需使用底涂剂改善;作为弹性体,硬度与强度远低于环氧树脂,不适用于结构支撑场景。
2.2.2.3 工程应用定位
有机硅是SMT领域“应力管理、宽温域密封与保护”的专家,核心适配场景为“对柔韧性、耐温性、电气绝缘性要求高”的场合,具体包括:
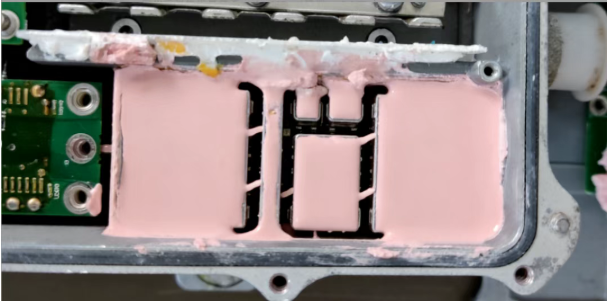
•应力缓冲:敏感元器件(如传感器、芯片)的应力保护,减少热循环、振动带来的损伤;
•宽温域密封:户外电子、车载电子、高温设备的密封(如LED路灯、发动机舱密封);
•电气保护:PCB板共形覆膜、电子元件的绝缘保护;
•LED封装:荧光粉胶(如DOWSIL™ OE系列),高透光、耐黄变,适配LED照明场景。
注意点:在需要高强度粘接的场景中,有机硅不可替代环氧树脂;使用时需注意底涂剂的匹配,避免粘接失效。
2.2.3 丙烯酸酯:高效生产的“应急先锋”(快速固化首选)
2.2.3.1 分子结构核心总结

丙烯酸酯胶粘剂主要指(甲基)丙烯酸酯类单体或低聚物,分子中含有不饱和双键(C=C),核心固化机理是“自由基聚合反应”——在光引发剂(UV固化)或热引发剂(热固化)的作用下,双键断裂、聚合形成线性或交联聚合物。SMT领域中,UV固化丙烯酸酯应用最广泛,其次是热固化型。
关键点总结:双键的活性决定固化速度,光引发剂的类型决定UV固化的波长适配性;通过调整单体、低聚物的种类,可灵活调控胶粘剂的粘度、硬度、柔韧性,可设计性强。

2.2.3.2 性能图谱与标杆产品解读(结合TDS参数)

丙烯酸酯的核心优势是“固化速度极快、粘接范围广、可设计性强”,短板是耐温性、耐化学性一般,固化收缩率较高。结合Panacol、DELO、汉高等标杆产品的TDS参数,其性能特点与应用场景总结如下:
1.固化速度极快(核心优势):UV固化型在紫外光照射下可在数秒内完全固化,热固化型也可在短时间内达到较高强度,大幅提升生产效率。
产品实例1:Panacol Structalit® 5115(UV固化胶),TDS标注适配365nm UV波长,固化时间仅需数秒,用于电子元器件快速固定,可将工序节拍缩短50%以上,是SMT高速生产线的首选贴片胶之一。
产品实例2:施奈仕丙烯酸结构胶,专为光通信领域定制,4~6分钟可实现初步固定,30分钟内达到80%强度,既保证高精度粘接,又大幅提升生产节奏,有效减少材料损耗,适配光学镀膜平台、晶圆级微纳光学平台的精密粘接需求。
产品实例3:DELO KATIOBOND®系列(微电子UV固化胶),在精密粘接领域口碑极佳,固化速度快且收缩率可控,适配光学元件、微型元器件的粘接。
2.粘接范围广:对金属、塑料、玻璃等多种基材均有较好的粘接能力,无需底涂剂,适配多基材混合组装场景。
3.可设计性强:通过调整单体、低聚物和添加剂,可灵活设计粘度(适配不同点胶工艺)、硬度(从软到硬)、颜色(透明、有色)等性能,满足不同场景需求。
4.耐温性与耐化学性一般:分子主链为C-C键,长期使用温度通常在80°C~120°C,耐溶剂、耐水汽能力不及环氧树脂和有机硅;固化收缩率较高(自由基聚合特性),可能引入内应力,不适用于精密封装。
2.2.3.3 工程应用定位
丙烯酸酯是SMT生产中“追求效率”的核心选择,核心适配场景为“快速固化、多基材粘接”的场合,具体包括:
•快速固定:元器件临时固定(贴片胶,如汉高乐泰3609,UV/热双重固化)、生产线快速修复;
•精密光学粘接:摄像头镜头、光学传感器、光通信元件的粘接(如Panacol Vitralit®系列、施奈仕定制款),高透光、低黄变,适配精密光学场景;

•多基材组装:金属与塑料、玻璃与塑料的混合粘接,无需底涂剂,简化工艺。
注意点:在高温、高湿度、耐化学性要求高的场景中,需避免使用普通丙烯酸酯;精密封装中需选用低收缩改性款,减少内应力。
2.2.4 聚氨酯:抗冲击的“坚韧铠甲”(动态载荷首选)
2.2.4.1 分子结构核心总结

聚氨酯是由异氰酸酯(-NCO)与多元醇(-OH)反应生成的嵌段共聚物,核心结构特点是“硬段与软段的微相分离”——硬段(异氰酸酯衍生结构)提供强度与模量,软段(多元醇衍生结构)提供柔韧性与弹性,这种“海岛结构”是其高韧性、抗冲击的核心原因,也是性能调控的关键。
关键点总结:软硬段的比例、种类、分子量决定聚氨酯的性能——硬段比例越高,强度、硬度越好;软段比例越高,柔韧性、弹性越好;可通过调整软硬段参数,制备从弹性体到硬塑料的多种材料。

2.2.4.2 性能图谱与标杆产品解读(结合TDS参数)

聚氨酯的核心优势是“高韧性、高耐磨性、可设计性强”,短板是耐温性中等、耐湿性不足,在SMT核心封装中应用不如环氧树脂广泛,但在特殊场景中不可替代。结合汉高等标杆产品,其性能特点与应用场景总结如下:
1.优异的韧性与耐磨性:硬段与软段的微相分离结构,使其能吸收大量冲击能量而不断裂,耐磨性能突出,优于环氧树脂。
产品实例:汉高乐泰PL Premium(工业级聚氨酯胶),用于需要承受动态载荷的部件粘接,抗冲击、耐磨,适配便携式设备的抗摔结构;在SMT领域,聚氨酯灌封胶可提供卓越的抗跌落保护,适用于手机、平板等易受冲击的电子产品。
2.可设计性强:通过调整软硬段比例,可制备从柔软弹性体(肖氏A硬度50以下)到坚硬塑料(肖氏D硬度80以上)的多种材料,适配不同强度、柔韧性需求。
3.良好的粘接性:分子链中的极性基团(-NCO、-OH)可与多种基材表面形成氢键,粘接强度较好,对金属、塑料、橡胶等基材均有良好的粘接效果。
4.耐温性中等,耐湿性不足:通用聚氨酯长期使用温度为80°C~120°C,高温高湿环境下易发生水解,需选用改性款(如耐水解聚氨酯)适配潮湿场景。
2.2.4.3 工程应用定位
聚氨酯是SMT领域“应对动态载荷、磨损环境”的多面手,核心适配场景为“高抗冲击、高耐磨性”的场合,具体包括:
•抗冲击灌封:便携式设备(手机、平板)的抗摔减振结构灌封,减少跌落时的器件损伤;
•耐磨粘接:硬盘磁头组件、机械传动部件的粘接,提升耐磨性与使用寿命;
•特殊结构粘接:需要兼顾强度与柔韧性的结构件粘接(如柔性PCB与刚性基板的粘接)。
注意点:在高温、高湿、耐化学性要求高的场景中,需选用耐水解、耐高温改性聚氨酯;SMT核心封装(如BGA底部填充)中,聚氨酯通常不替代环氧树脂。
2.2.5 四大胶粘剂核心差异总结
胶粘剂类型 | 核心优势 | 核心短板 | 标杆产品 | 核心应用场景 |
环氧树脂 | 高强高刚、低收缩、耐化学性优、耐温可调 | 韧性不足(可改性) | Loctite EA 9494、Indium UF8900、Loctite 3525 | BGA底部填充、芯片粘接、结构加固、高温场景 |
有机硅 | 宽温域、高柔性、电气绝缘优、耐候性好 | 粘接强度、机械强度低 | DOWSIL™ 3-6750、DOWSIL™ 1-2577 | 应力缓冲、宽温密封、共形覆膜、LED封装 |
丙烯酸酯 | 快速固化、粘接范围广、可设计性强 | 耐温性、耐化学性一般,收缩率高 | Structalit® 5115、Loctite 3609、施奈仕定制款 | 快速贴片、光学粘接、多基材组装、快速修复 |
聚氨酯 | 高韧性、高耐磨性、可设计性强 | 耐温性中等、耐湿性不足 | Loctite PL Premium、聚氨酯灌封胶 | 抗冲击灌封、耐磨粘接、柔性结构粘接 |
2.3 关键性能指标:从TDS参数到工程实践
如果说分子结构是胶粘剂的“基因”,那么关键性能指标就是胶粘剂的“体检报告”——它是连接材料科学与工程应用的桥梁,也是SMT工程师选型、工艺优化的核心依据。很多工程师在实际工作中,往往只关注“粘接强度”这一个指标,忽略了其他关键参数,导致产品失效。
本节将从工程实践出发,系统总结SMT点胶胶粘剂的三大类关键性能指标(热机械性能、机械可靠性、特殊功能),解读其工程意义、测试方法,并结合标杆产品的TDS参数与真实案例,说明如何通过参数判断胶粘剂的适配性,避免选型失误。
2.3.1 热机械性能:决定胶粘剂的“环境适应性”(核心指标)
热机械性能是胶粘剂在温度变化过程中的力学行为,核心指标包括玻璃化转变温度(Tg)、热膨胀系数(CTE)、模量——这三个指标直接决定了胶粘剂在不同温度环境下的稳定性,也是导致热疲劳失效的核心因素。
2.3.1.1 玻璃化转变温度(Tg):耐热性能的“核心标尺”
工程意义:Tg是胶粘剂从“玻璃态”(坚硬、脆性)转变为“橡胶态”(柔软、有弹性)的临界温度,是衡量胶粘剂耐热性能的核心指标——当使用温度低于Tg时,胶粘剂保持刚性,可提供可靠的机械支撑;当使用温度高于Tg时,胶粘剂软化、模量骤降,失去结构支撑能力,可能导致封装失效。
选型原则:实际使用温度应低于Tg至少20°C,确保胶粘剂在服役过程中始终处于玻璃态(结构支撑场景);若为应力缓冲场景(如有机硅),则需选择Tg极低的产品,确保宽温域内保持弹性。
产品实例解读(结合TDS):
•汉高乐泰EA 9494:TDS标注Tg=155°C(DMA,10Hz),适用于汽车发动机舱(使用温度约125°C),125°C<155°C-20°C,可长期保持刚性,提供可靠支撑;
•陶氏DOWSIL™ 3-6750:有机硅类,Tg<-50°C,适用于极寒环境(如北极户外电子),即使在-55°C仍保持弹性,不会脆化开裂;
•普通丙烯酸酯:Tg通常在80°C~100°C,不适用于高温场景,仅适配室温、中温应用(如消费电子常规封装)。
测试方法:差示扫描量热法(DSC)、动态机械分析法(DMA),其中DMA测试更贴合工程实际,可精准获取Tg值。
2.3.1.2 热膨胀系数(CTE):热疲劳失效的“隐形杀手”
工程意义:CTE是指材料在温度变化1°C时,单位长度的膨胀(或收缩)量,单位为ppm/°C。在SMT封装中,芯片(Si,CTE≈2.6ppm/°C)、PCB基板(FR-4,CTE≈16ppm/°C)、胶粘剂的CTE差异(CTE失配),会在高低温循环过程中产生热应力,长期循环会导致焊点开裂、胶层脱落,是热疲劳失效的首要原因。
选型原则:胶粘剂的CTE应介于芯片与基板之间,且与两者的差值越小越好,以缓解热应力;精密封装(如BGA、CSP)需选用低CTE胶粘剂(通常<35ppm/°C)。

产品实例解读(结合TDS):
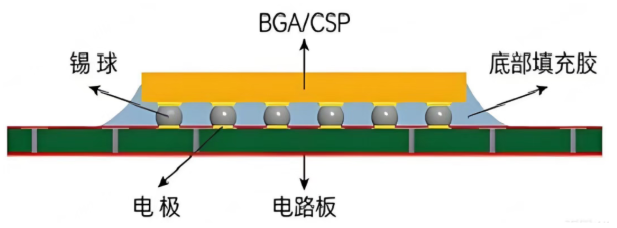
•铟泰Indium UF-8800(底部填充胶):TDS标注玻璃态CTE≈32ppm/°C,介于硅芯片(2.6ppm/°C)与FR-4基板(16ppm/°C)之间,可有效缓解热循环应力,减少焊点开裂风险;
•汉高乐泰EA 9494:玻璃态CTE≈32ppm/°C,与UF-8800接近,适配高可靠性底部填充场景;
•普通有机硅:CTE通常在100ppm/°C以上,不适用于精密封装,仅用于应力缓冲场景(通过高柔性吸收热应力)。
测试方法:热机械分析法(TMA),可分别测试玻璃态、橡胶态下的CTE值,为选型提供依据。
2.3.1.3 模量:结构支撑与应力分配的“关键参数”
工程意义:模量是衡量材料“刚度”的指标,单位为GPa(或MPa),模量越高,材料越坚硬,结构支撑能力越强;模量越低,材料越柔软,应力吸收能力越强。模量与CTE协同作用,共同决定热应力的大小与分配——高模量胶粘剂可约束基材变形,将应力转移到胶层;低模量胶粘剂可通过自身变形吸收应力,减少基材损伤。
选型原则(专家经验):结构支撑场景(如底部填充、芯片粘接)选用高模量胶粘剂(通常>5GPa);应力缓冲场景(如敏感元器件保护)选用低模量胶粘剂(通常<100MPa)。
产品实例解读(结合TDS):
•汉高乐泰EA 9494:25°C下模量≈9.5GPa,高模量可有效约束BGA焊点,将热应力从焊点转移到胶层,提升焊点可靠性;
•陶氏DOWSIL™ 1-2577(共形覆膜胶):模量为MPa级别,低模量可通过自身变形吸收热应力、振动应力,保护PCB电路;
•汉高乐泰3525(增韧环氧):模量≈8GPa,兼顾强度与韧性,适配抗冲击结构粘接场景。
测试方法:动态机械分析法(DMA)、万能材料试验机,其中DMA可测试不同温度下的模量变化,更贴合实际使用场景。
案例说明:BGA焊点热疲劳失效分析
【事故背景】某通信设备(基站核心部件)在经历2000次高低温循环(-40°C~125°C)后,出现间歇性信号故障,拆机后发现BGA角部焊点断裂,批量故障率达15%,影响产品交付。
【失效分析】通过FEA(有限元分析)模拟与失效件检测,确定根本原因:未使用底部填充胶,芯片(CTE≈2.6ppm/°C)与FR-4基板(CTE≈16ppm/°C)的CTE失配,导致高低温循环过程中,BGA角部焊点承受最大剪切应力,长期循环后发生疲劳断裂。
【材料选型与优化】工程团队引入底部填充胶,基于TDS参数筛选两款候选产品,进行量化对比:
参数 | 候选A:Loctite EA 9494 | 候选B:Indium UF-8900 | 选型要求 |
Tg | 155°C | 135°C | >125°C+20°C=145°C |
CTE(T<Tg) | ≈32ppm/°C | ≈30ppm/°C | <35ppm/°C,介于芯片与基板之间 |
模量(25°C) | 9.5GPa | 7.0GPa | >7GPa,可有效约束焊点 |
【决策与验证】结合应用场景(通信设备对机械刚性要求极高),最终选择模量更高的Loctite EA 9494——高模量可更有效地约束焊点变形,转移热应力。优化后,FEA模拟显示焊点最大剪切应力降低70%以上;实际测试中,器件通过20000次高低温循环无失效,故障率降至0.1%以下。
【专家总结】此案例充分说明:热机械性能(Tg、CTE、模量)的协同匹配,是避免热疲劳失效的关键;选型时需结合实际使用温度、基材CTE,量化参数对比,而非单纯追求某一项指标。
2.3.2 机械可靠性:决定胶粘剂的“粘接耐久性”(核心指标)
机械可靠性是胶粘剂粘接能力的直接体现,核心指标包括剪切强度、断裂韧性——剪切强度决定胶粘剂的“粘接力度”,断裂韧性决定胶粘剂的“抗冲击能力”,两者共同决定了粘接部位的耐久性,尤其在动态载荷、冲击场景中至关重要。
2.3.2.1 剪切强度:粘接能力的“直接标尺”
工程意义:剪切强度是指胶粘剂在剪切力作用下的最大承载能力,单位为MPa,是评价胶粘剂粘接性能最直接、最常用的指标——它直接决定了粘接部位能否抵抗生产过程(如波峰焊、回流焊)和使用过程(如振动、冲击)中的剪切力,避免元器件脱落、胶层开裂。
选型原则(专家经验):根据应用场景确定剪切强度要求——普通贴片胶需≥10MPa(可抵抗波峰焊冲击力);结构粘接胶需≥20MPa(如芯片粘接、抗冲击结构);临时固定胶可适当降低(≥5MPa)。
产品实例解读(结合TDS):
•汉高乐泰3525(增韧环氧):TDS标注铝/铝搭接剪切强度≈22MPa,远高于普通贴片胶要求,适用于结构粘接(如摄像头模组、芯片加固);
•汉高乐泰3609(贴片胶):剪切强度≈10-15MPa,可满足常规贴片固定需求,抵抗波峰焊冲击力;
•陶氏DOWSIL™ 3-6750(有机硅密封胶):剪切强度≈2-5MPa,粘接强度低,仅用于密封、缓冲,不可用于结构粘接。
测试方法:搭接剪切强度测试(ASTM D1002),采用标准试样(铝/铝或钢/钢搭接),通过万能材料试验机测试剪切断裂时的最大应力,结果更具参考性。
2.3.2.2 断裂韧性:抗冲击能力的“核心指标”
工程意义:断裂韧性是衡量胶粘剂抵抗裂纹扩展的能力,单位为MPa·m^0.5(KIC值),比剪切强度更能反映胶粘剂在动态载荷、冲击场景中的性能——很多胶粘剂剪切强度高,但韧性差,在冲击、振动作用下易发生脆性断裂,导致产品失效(如便携式设备跌落、工业设备振动)。
选型原则:静态载荷场景(如固定、密封),重点关注剪切强度;动态载荷、冲击场景(如手机、户外设备),重点关注断裂韧性,优先选用KIC值≥1.5MPa·m^0.5的增韧型产品。
产品实例解读(结合TDS与应用经验):
•普通环氧树脂:KIC值≈0.5-0.8MPa·m^0.5,韧性差,易脆性断裂,不适用于抗冲击场景;
•汉高乐泰3525(增韧环氧):通过核-壳橡胶改性,KIC值≥1.5MPa·m^0.5,断裂韧性大幅提升,可吸收冲击能量,适用于抗冲击结构粘接;
•聚氨酯胶:KIC值≈1.2-2.0MPa·m^0.5,韧性优异,适用于动态载荷场景(如抗跌落灌封)。
注意点:多数胶粘剂的TDS不会直接标注KIC值,可通过产品描述(如“高韧性”“抗冲击”)和冲击测试数据(如简支梁冲击强度)间接判断。
测试方法:单边缺口梁法(SENB)、楔入测试,其中SENB法可精准测试KIC值,贴合工程实际需求。